全国24小时服务热线:
13302910083AI 算力驱动光模块代际升级,设备需求进入高景气周期。AI 训练与推理集群规模持续扩大,光模块速率由400G 全面迈向800G 并加速向1.6T 升级,出货结构向高端规格快速倾斜。高速率产品对贴片精度、耦合稳定性、 测试带宽与一致性要求显著提升,推动设备向高精度、高自动化、高一致性方向升级。同时,架构由传统可插 拔向CPO/OIO演进,新增先进封装与一体化测试需求,带动单位产线设备投资额抬升。需求扩张叠加技术升级, 设备端迎来量增+价升的双重驱动。

贴片、耦合与测试为高价值核心环节,行业空间快速扩容。 光模块封装流程涵盖贴片、键合、耦合与测试,其 中耦合与测试为价值量最高环节,合计占比超过60%。800G及以上产品对耦合精度提升至0.05 μm级,对自动化 平台稳定性与重复定位能力提出更高要求;测试环节由分立仪器向一体化ATE 平台升级,老化测试、功能测试 及AOI在线检测成为规模化量产标配。随着高端规格占比提升,单条产线设备投入持续上行,全球光模块封测 设备市场有望实现翻倍扩容,设备行业景气度具备较强延续性。
传统的光模块封装测试的流程可以概括为贴片、键合、光学耦合、组装、测试等。生产流程的核心是光电器 件精密封装+光电信号集成+全流程可靠性验证。传统分立器件方案以EML 激光器+分立光学件为核心, 主打10G~800G电数通模块,核心是TOSA/ROSA 光组件封装,有源耦合是核心瓶颈
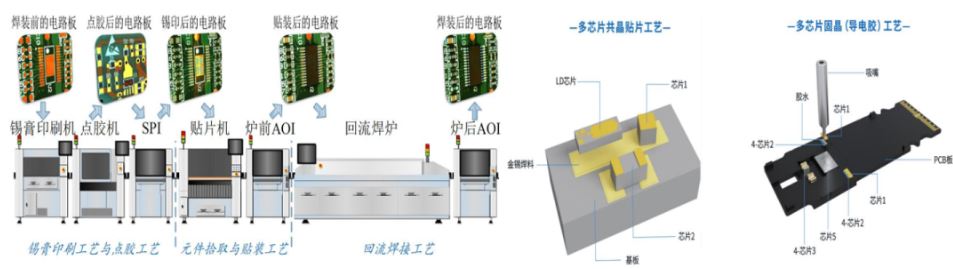
贴片机是在光模块封装过程中,将光芯片、驱动IC 、TIA ( 跨阻放大器)等光电元器件以高精度和高速度贴装 到电路板上的自动化设备。主要流程为,在PCB 贴装区域的焊盘上涂覆一层锡膏,将表面贴装元件放置在对应 的位置,再通过回流焊使锡膏熔化将表面贴装元件焊接在PCB 单侧的焊盘上完成电气连接,能够实现功能复杂 的多层电路板封装,更加便于进行自动化生产,提高生产效率。
根据工艺不同,贴片工艺可分为共晶和固晶。①共晶贴片: 利用低熔点合金材料(如AuSn 焊料),在高温加 压下使芯片与基板形成共晶结合,适用于激光器、功率器件等高散热、高可靠场景需求的封装,工艺复杂,需 精准温控和压力控制。②固晶贴片:利用导电银胶在芯片底部和基板上进行粘接,使用范围广、效率高,适用 于电芯片、PD 等大批量、常规场景的装贴。
国产替代+自动化升级+先进封装导入,设备厂商迎结构性机会。中低端环节国产化率已较高,但高精度贴片、 金丝键合、高端测试仪器等领域仍由海外主导,进口替代空间广阔。光模块行业过往为劳动密集型,随着海外 建厂与人工成本上升,自动化、整线化解决方案成为扩产核心路径。进一步看,CPO/OIO 将光模块封装推向半 导体级先进封装阶段,引入2.5D/3D封装、TSV 、混合键合等工艺。
投资建议:重点推荐罗博特科(耦合设备)、路远(贴片、耦合机)、凯格精机(封装、贴片机)、博特思(测试仪器仪表)、迈思泰克(AOI 设备)。
